2022-11-01 0
晶圆切割(即芯片)是芯片制造过程中不可或缺的过程,属于晶圆制造的后一个过程。晶圆切割是将芯片的整个晶圆根据芯片的大小分成单个芯片(晶粒)。

最早的晶圆用切片系统进行切割(划片),这种方法以往占据了世界芯片切割市场的较大份额,特别是在非集成电路晶圆切割领域。钻石锯片(砂轮)切割方法是一种更常见的晶圆切割方法。新的切割方法是激光进行无切割处理。
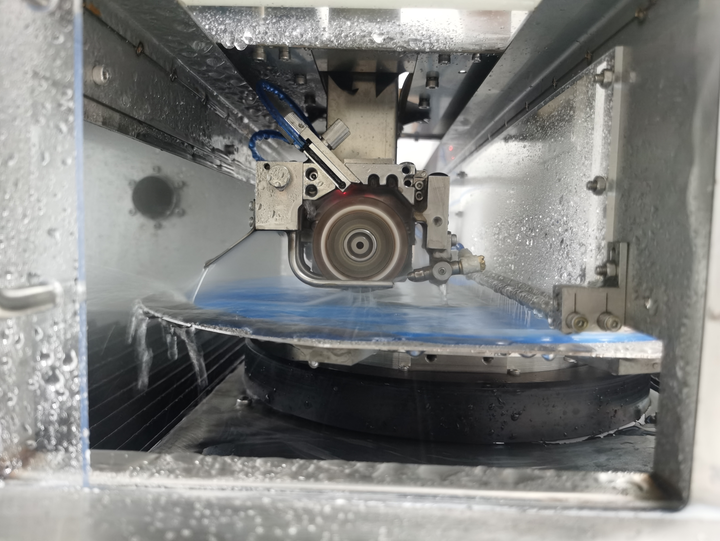
晶圆切割过程主要包括:贴膜、切割、解UV胶。
将晶圆切割成单独的晶圆die切割高速旋转的金刚石刀片,形成独立的单晶,为后续工艺做准备。晶圆切割需要特定的切割机刀片。
绷带是切割前的晶圆固定过程,在晶圆背面贴一层蓝膜,固定在金属框架上,有利于后切。

切割过程中需要去离子水(DI纯水)冲洗切割产生的硅渣,释放静电,专业制备的小型设备去离子水「纯水机」制备。
UV照射是用紫外线映照切割的蓝膜,以降低蓝膜的粘度,方便后续挑粒。
138-2371-2890
