2022-07-09 0
氧化
氧化过程的作用是在晶圆表面形成保护膜。它可以保护晶圆不受化学杂质影响、避免漏电流进入电路、预防离子植入过程中的扩散以及防止晶圆在刻蚀时滑脱。 氧化过程的第一步是去除杂质和污染物,需要通过四步去除有机物、金属等杂质及蒸发残留的水分。清洁完成后就可以将晶圆置于800至1200摄氏度的高温环境下,通过氧气或蒸气在晶圆表面的流动形成二氧化硅(即“氧化物”)层。氧气扩散通过氧化层与硅反应形成不同厚度的氧化层,可以在氧化完成后测量它的厚度。
氧化过程的第一步是去除杂质和污染物,需要通过四步去除有机物、金属等杂质及蒸发残留的水分。清洁完成后就可以将晶圆置于800至1200摄氏度的高温环境下,通过氧气或蒸气在晶圆表面的流动形成二氧化硅(即“氧化物”)层。氧气扩散通过氧化层与硅反应形成不同厚度的氧化层,可以在氧化完成后测量它的厚度。
干法氧化和湿法氧化
根据氧化反应中氧化剂的不同,热氧化过程可分为干法氧化和湿法氧化,前者使用纯氧产生二氧化硅层,速度慢但氧化层薄而致密,后者需同时使用氧气和高溶解度的水蒸气,其特点是生长速度快但保护层相对较厚且密度较低。
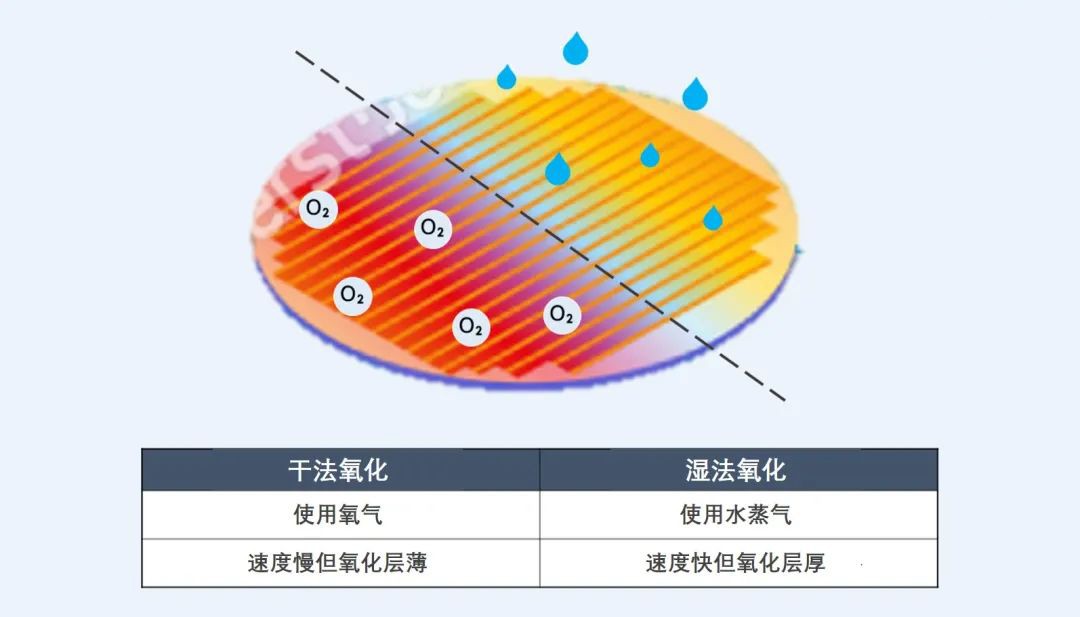
除氧化剂以外,还有其他变量会影响到二氧化硅层的厚度。首先,晶圆结构及其表面缺陷和内部掺杂浓度都会影响氧化层的生成速率。此外,氧化设备产生的压力和温度越高,氧化层的生成就越快。在氧化过程,还需要根据单元中晶圆的位置而使用假片,以保护晶圆并减小氧化度的差异。
138-2371-2890
