2023-03-25 0
半导体产品的制造过程主要包括前道晶圆制造和后道封装测试,随着先进封装技术的浸透,呈现了介于晶圆制造和封装之间的加工环节,称为中道)。半导体产品的加工工序多,在制造过程中需求大量的半导体设备。在这里,我们引见传统封装(后道)的八道工艺。
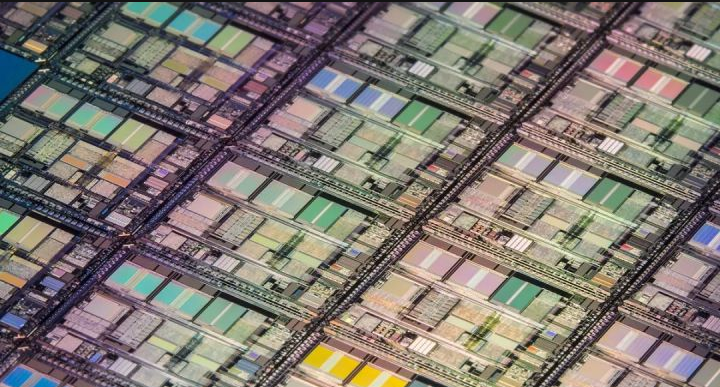
传统封装工艺大致能够分为反面减薄、晶圆切割、晶圆贴装、引线键合、塑封、激光打印、切筋成型和废品测试等8个主要步骤。与IC晶圆制造(前道)相比,后道封装相对简单,技术难度较低,对工艺环境、设备和资料的请求远低于晶圆制造。
反面减薄
由于制造工艺的请求,对晶片的尺寸精度、几何精度、外表干净度等都提出很高的请求,因而在几百道工艺流程中只能采用一定厚度的晶片在工艺过程中传送、流片。通常在集成电路封装前,需求对晶圆反面多余的基体资料去除一定的厚度,这一过程称之为晶圆反面减薄工艺,对应配备是晶圆减薄机。
晶圆切割
依据晶圆工艺制程及客户的产品需求,一片晶圆通常由几百至数万颗小芯片组成,业内大局部晶圆上的Dice之间有着40um-100um不等的间隙辨别,此间隙被称为划片街区(切割道)。而圆片上99%的芯片都具有独立的性能模块(1%为边缘Dice,不具备运用性能),为将小芯片别离成单颗Dice,就需采用切割的工艺停止切割别离,此工艺过程叫做晶圆切割。

晶圆贴装
晶圆贴装的目的将切割好的晶圆颗粒用银膏粘贴在引线框架的晶圆庙上,用粘合剂将已切下来的芯片贴装到引线框架的中间燥盘上。通常是环氧(或聚酰亚胺)用作为填充物以增加粘合剂的导热性。
引线键合
引线键合的目的是将晶圆上的键合压点用极细的金线衔接到引线框架上的内引脚上,使得晶圆的电路衔接到引脚。通常运用金线的一端烧成小球,再将小球键合在第一焊点。然后依照设置好的程序拉金线,将金线键合在第二焊点上。

塑封
将完成引线键合的芯片与引线框架置于模腔中,再注入塑封化合物环氧树脂用于包裹住晶圆和引线框架上的金线。这是为了维护晶圆元件和金线。塑封的过程分为加热注塑、成型两个阶段。塑封的目的主要是:维护元件不受损坏;避免气体氧化内部芯片;保证产品运用平安和稳定。
激光打印
激光打印是用激光射线的方式在塑封胶外表打印标识和数码。包括制造商的信息,器件代码,封装日期,能够作为辨认和可追溯性。
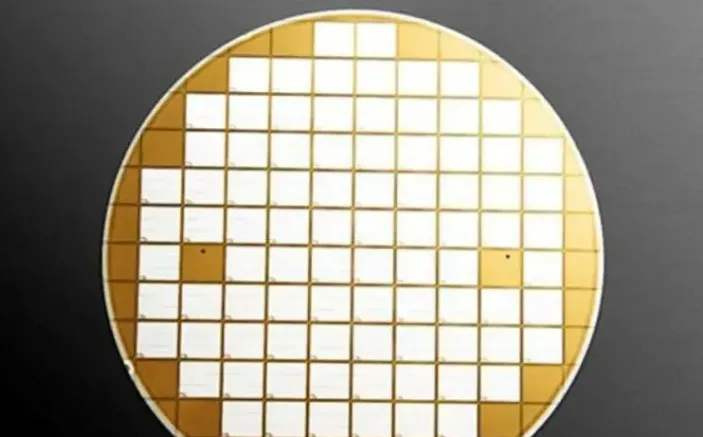
切筋成型
将原来衔接在一同的引线框架外管脚切断别离,并将其弯曲成设计的外形,但不能毁坏环氧树脂密封状态,并防止引脚扭曲变形,将切割好的产品装入料管或托盘便于转运。
废品测试
检测产品的外观能否能契合设计和规范。常见的的测试项目包括:引脚平整性、共面性,引脚间的脚距,塑封体能否损伤、电性能及其它功用测试等。

138-2371-2890
