2022-05-12 0
集成电路从电子管到超大规模集成电路的方向发展,IC集成度越高,伴随对封装技术的要求也是越发的精细化。划片机是IC封装生产过程中的关键设备之一,用于将含有很多芯片的晶圆切割成一个个晶片颗粒,其切割加工能力一定程度上决定了芯片封装的成品率与性能。IC晶圆,一般由硅(Si)构成,分为6英寸、8英寸、12英寸规格不等,晶片就是基于wafer制造而成。IC需要将Wafer上的一个子单元即一个晶片颗粒从晶圆体上分割得到。
IC封装简介
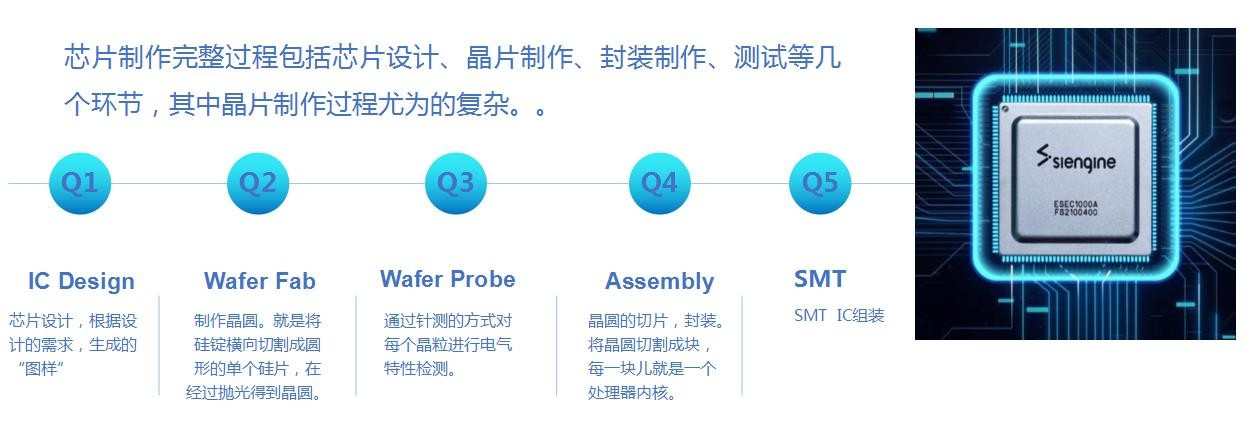
FOL– Front of Line前段工艺

必不可少的工艺流程
通过流程可以看出,Wafer并非成品IC芯片,需要经过一系列复杂工艺流程去完成,切割是必须工艺。
一直以来,相关领域都由国外垄断,对中国半导体行业进行技术封锁,由于市场的需求,经过行业的不断努力,国产Wafer设备已经有很大进步,博捷芯的产品现已完全可以替代进口设备。国产化的需求缺口在增大,市场蓝海属于掌握核心技术的团队。
Wafer Saw晶圆切割
将晶圆粘贴在蓝膜(Mylar)上,使得即使被切割开后,不会散落;
通过Saw Blade将整片Wafer切割成一个个独立的Dice,方便后面的 Die Attach等工序;
Wafer Wash主要清洗Saw时候产生的各种粉尘,清洁Wafer;

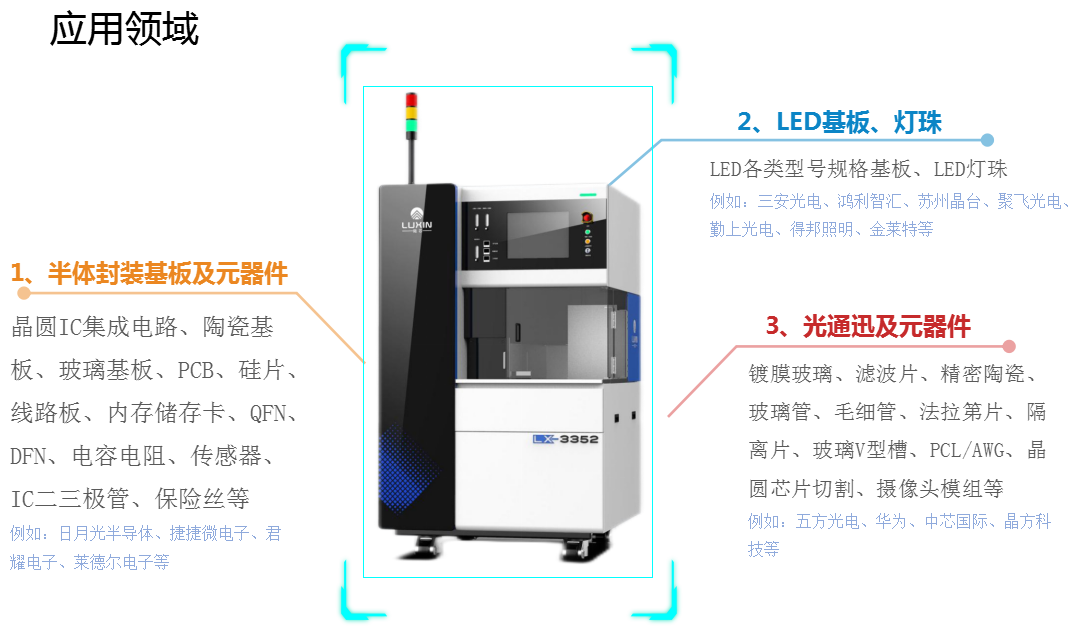
138-2371-2890
