2022-03-10 0
单次切割,即一次完全切割硅片,切割深度到UV膜厚度1/2的位置,如下图所示。该方法工艺过程简单,适合超薄材料切割,但切割过程刀具磨损严重,切割道边缘易产生崩边和毛刺,工件因受磨削力的影响,材料表面及亚表面易产生裂纹等缺陷。
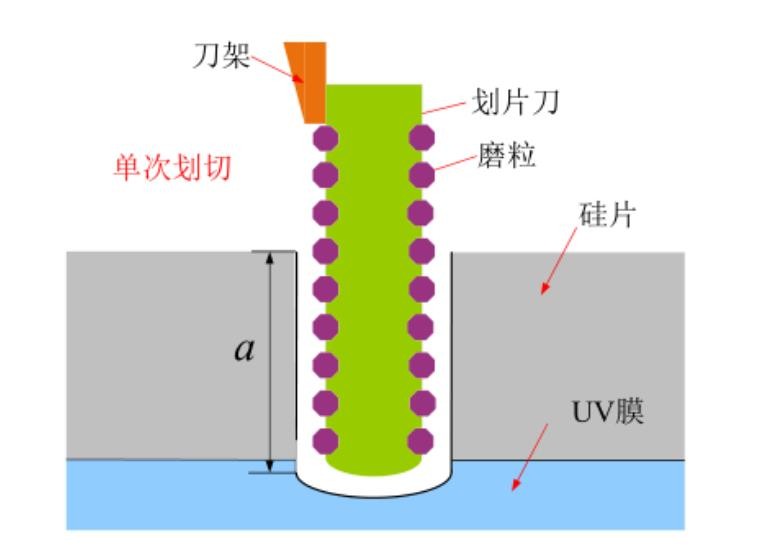
针对硬脆材料划切工艺缺陷,本文提出一种分层划切工艺方法,如下图所示。根据切割材料的厚度,在划切深度方向采用分层(阶梯式)进给的方式进行划切,首先进行开槽划切,采用比较小的进给深度,以保证刀具受力小,降低刀具磨损,减小切割道正面崩边,然后再沿着第一刀划切道继续进行划切。
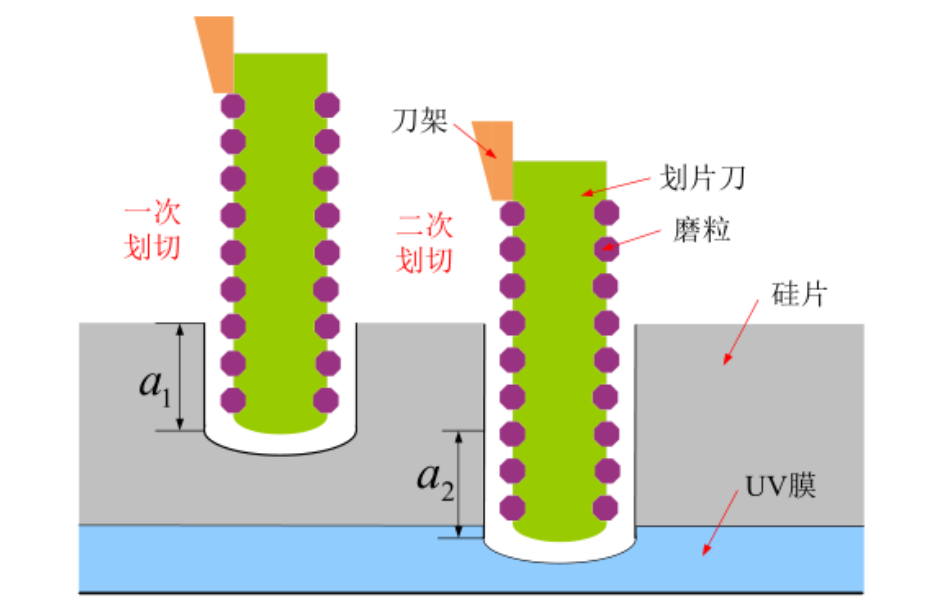
两种切割方式切割过程中切割膜的厚度需要保证,当切割膜过深,将切透膜,导致工件盘失去真空能力而无法固定硅片;当切割膜过浅,将导致硅片背面崩边严重,因此,切割过程对最后一次切割的深度必须保证。

138-2371-2890
