2022-01-07 0
砂轮划片和激光划片是硅片的两种主要划片方式。从理论和工艺测试层面分析了两种划片工艺的优缺点,提供了一种适合硅片划片的方法。砂轮和激光复合划片工艺方案,提供工艺参数和测量数据,具有良好的工程应用价值。

1、硅片切割是集成电路封装工艺中晶圆上多个芯片图形切割工艺中的关键工序,要求芯片沿切割路径完全分离。传统的加工方法是在晶圆背面贴上一层蓝膜,用砂轮刀片将晶圆完全切开,不会划伤蓝膜。由于机械应力的存在,切割槽的背面容易出现崩刃。此外,对于切割通道中带有玻璃和低K电介质等保护层的晶圆,保护层容易开裂脱落,影响芯片性能。

2、激光划片属于非接触式加工,不会产生崩刃、刀具磨损和水污染,但热影响和夹渣是不可忽视的问题。即使冷加工355nm紫外激光或超快激光,仍具有一定的热效应。另一个考验是激光聚焦无法精确控制到刀具的深度,晶圆完全切穿时,蓝膜往往会被破坏,影响后续的晶体膨胀过程。使用特殊的激光切割胶带可以在一定程度上解决这个问题,但余热必须控制在胶带的损坏阈值内,使用胶带增加了生产成本。
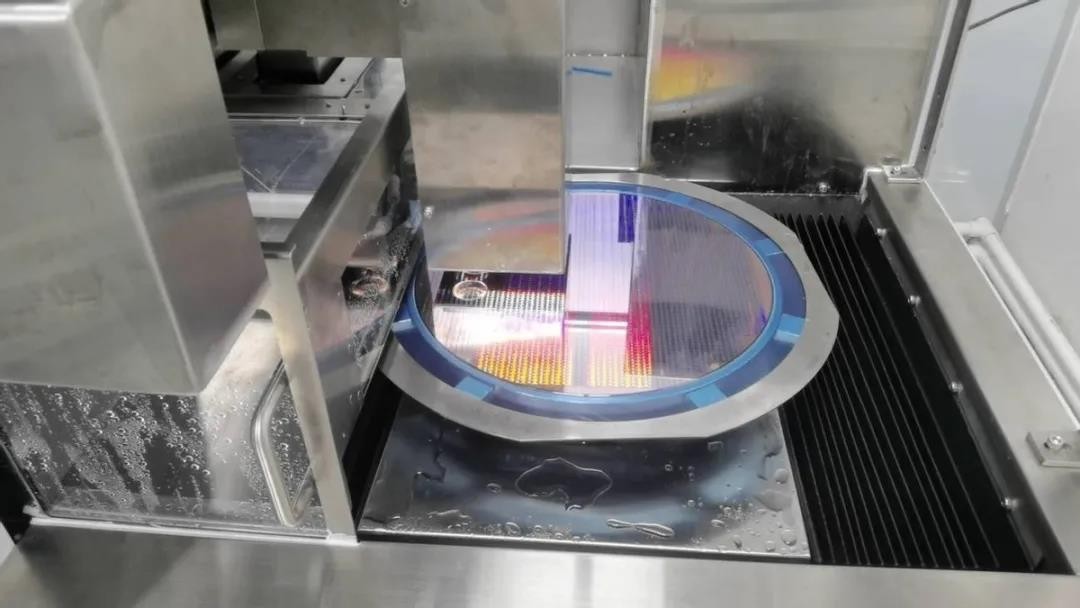
结合二款设备砂轮划片和激光划片的优点。硅晶片切割划片更加建议采用砂轮划片机来进行切割加工,有效的保障产品的成功率,通过大量的工艺测试和测量分析,验证了该方法可以达到理想的加工质量。
138-2371-2890
